| |
Ёшио Накано
Новые IGBT-модули фирмы Hitachi
Четвертое поколение IGBT-модулей фирмы Hitachi на базе планарной технологии с самосовмещением позволяет уменьшить прямые потери, улучшить шумовые характеристики, обеспечить более эффективный теплоотвод, а значит повысить долговечность изделия и его термическую прочность.
Как известно, IGBT характеризуются высокой скоростью переключения, возможностью управления напряжением, подобно полевым транзисторам, и, в то же время, низким уровнем напряжения насыщения и способностью управлять большой мощностью, характерной для биполярных транзисторов. Тем не менее, производители этих изделий непрерывно работают над улучшением их основных параметров. В настоящей статье представлены основные результаты, достигнутые фирмой Hitachi в чётвертом поколении IGBT-модулей с улучшенными характеристиками, которые включают:
- пониженное напряжение Vge(sat), снижающее прямые потери;
- улучшенные шумовые характеристики — пониженный уровень шумов коммутации и повышенная скорость переключения;
- низкое тепловое сопротивление, обеспечивающее более эффективный теплоотвод;
- передовые инженерные решения, повышающие долговечность изделия и его термическую прочность.
Однако, прежде, чем рассмотреть характеристики IGBT-модулей четвёртого поколения, рассмотрим технологию “затвора с изолирующими канавками” (trench gate), которая обеспечивает низкий уровень напряжения насыщения за счёт повышения плотности каналов в кристалле и использует вертикальную структуру затвора вместо традиционной горизонтальной.
Уменьшение размера кристалла, обычно используемое в канальных IGBT-модулях, частично компенсирует влияние стоимости более сложного технологического процесса производства и обычно более низкого процента выхода готовых изделий.
Однако, уменьшение размеров кристалла увеличивает полное тепловое сопротивление Rqjc. Входная ёмкость (Cjes) канальной MOS-структуры приблизительно вдвое меньше, чем у аналогичных изделий третьего поколения IGBT-модулей. Это требует разработки новой схемы управления затвором, которая не совместима с существующими.
Кроме того, канальная технология в значительной степени увеличивает ток короткого замыкания и требует дополнительной схемы “защиты от защёлкивания” (NLU), которая включается в модуль и соответственно повышает его стоимость.
В четвертом поколении IGBT-модулей используется передовая планарная технология, что позволяет избирательно получать лучшие характеристики n-слоя с самосовмещающейся ячеистой структурой. Самосовмещающаяся структура используется уже достаточно давно, поскольку границы раздела, являющиеся к тому же изоляторами в MOS-каналах, выступают одновременно в качестве источника диффузии для формирования n-слоя, выравнивающегося самостоятельно, поскольку при обычной технологии структура требует применения выравнивающей маски.
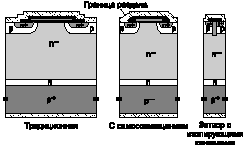
Рис. 1. Структура ячейки IGBT-модулей
Рис. 1 показывает структуру ячейки IGBT-модуля для обычной планарной технологии (III поколение), планарной технологии с самосовмещением (IV поколение) и технологии затвора с изолирующими канавками.
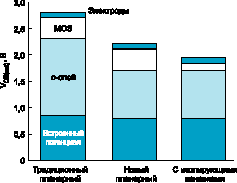
Рис. 2. Сравнительное снижение напряжения насыщения IGBT
На рис. 2 показаны четыре различных уровня напряжения насыщения для обычной планарной технологии (III поколение), новой планарной технологии с самосовмещением (IV поколение) и технологии затвора с изолирующими канавками.
Падение напряжения в n-слое является доминирующим, особенно для IGBT-модулей с номиналом выше, чем 1200 В.
Смещение проводимости в область n-слоя, очевидно, более эффективно, нежели формирование MOS-каналов, поскольку это уменьшает напряжение насыщения и не требует использования более сложной технологии затвора с изолирующими канавками.
Новая модифицированная планарная технология требует оптимизации локального управления временем жизни носителей в области p-n-перехода, не создавая при этом негативных эффектов в n-слое. Такая оптимизация решает задачу управления временем жизни носителей и в n-слое в целом, который имеет тенденцию к увеличению напряжения насыщения вследствие эмиссионных эффектов. Таким образом, в IGBT IV поколения планарный конструктив кристалла, дополненный локальным средством управления временем жизни носителей, позволяет уменьшить напряжение насыщения Vсе(sat) и потери переключения.
Для IGBT-модулей на напряжение 1200 В значение Vct(sat) удалось уменьшить с 2,2 до 0,5 В и снизить потери переключения на 25%.
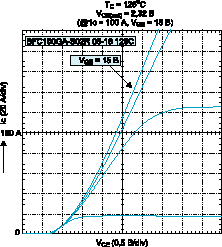
Рис. 3. Выходные характеристики IGBT-модуля IV поколения
Рис. 3 иллюстрирует выходные характеристики IV поколения IGBT-модулей, а на рис. 4 сравниваются уровни напряжения насыщения для планарных из-делий III и IV поколений.
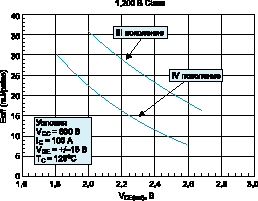
Рис. 4. Сравнительные характеристики напряжения насыщения для IGBT (1200 В) III и IV поколений
Также, одновременно с улучшением характеристик IGBT, улучшена работоспособность рекуперативного диода в самом модуле. В общих чертах, улучшение показателей IGBT-модулей привело к более быстрому включению, приводящему к уменьшению потерь переключения. Тем не менее, рост отношения di/dt в модуле ведёт к более крутому росту di/dt рекуперативного диода, что увеличивает уровень шума. Следовательно, параметры диода также должны быть улучшены аналогично параметрам самого модуля и скорость переключения повышена. Мягкое восстановление, поддерживая быстро переключение, обусловливает низкий уровень шумов IGBT.
Быстрые самовосстанавливающиеся диоды (SFD), разработанные для III поколения IGBT-модулей, скомбинированы с глубоким планарным и поверхностным p-n-переходом. Глубокий планарный переход обеспечивает низкий уровень обратного напряжения (Vf), а поверхностный переход содействует более плавному и быстрому восстановлению, которое снижает влияние тока выключения.
Ультрабыстрые самовосстанавливающиеся диоды, (USFD) разработанные для IV поколения IGBT-модулей, оптимизируют толщину и проводимость n-слоя. Это обеспечивает более плавный и медленный ток основных носителей через n-слой.

Рис. 5. Характеристики переключения для III и IV поколения IGBT
На рис. 5 показаны сравнительные кривые характеристик переключения для III и IV поколений IGBT-модулей.
Для увеличения количества рабочих циклов и долговечности, в IV поколении IGBT-модулей используется изолятор на основе нитрида алюминия и новый тип оптимизированной структуры алюминиевой металлизации кремниевой поверхности электродов.
При этом увеличение площади проводящих соединений увеличивает силу адгезии проводников выходных электродов. В результате, IV поколение IGBT-модулей обеспечивает вдвое большее количество рабочих циклов, нежели изделия III поколения (рис. 6).
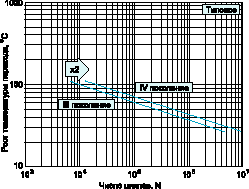
Рис. 6. Характеристики долговечности для IGBT III и IV поколения
Характеристики инвертора
Измерение потерь мощности производилось на устройстве управления двигателем переменного тока. Результаты приведены на рис. 7.
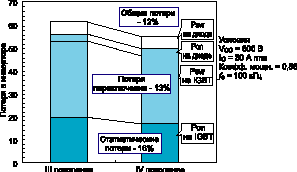
Рис. 7. Сравнительные потери инвертора на IGBT (1200 В, 100 А) III и IV поколений
По сравнению с III поколением, IGBT-модули IV поколения уменьшают общие потери мощности в инверторе на 12%.
Таблица. Семейство IGBT-модулей фирмы HITACHI
| HITACHI IV поколение "GR серия" |
| Ic |
Vce |
| одинарный |
двойной |
| 1,700 В |
1,200 В |
1,200 В |
600 В |
| 100 A |
|
|
MBM100GR12 |
|
| 150 A |
|
|
MBM150GR12 |
MBM1500GR6 |
| 200 A |
|
|
MBM200GR12 |
MBM200GR6 |
| 300 A |
|
|
MBM300GR12 |
MBM300GR6 |
| 400 A |
|
MBN400GR12 |
|
MBM400GR6 |
| 600 A |
|
MBN600GR12 |
|
|
| 800 A |
MBN800GR17 |
MBN800GR12 |
|
|
| 1200 A |
MBN1200GR17 |
MBN1200GR12 |
|
|
| "GS серия" |
| Ic |
Vce |
| одинарный |
двойной |
six-pack |
| 1,200 B |
1,200 B |
600 B |
1,200 B |
600 B |
| 75 A |
|
MBM75GS12AW |
|
MBB75GS12AW |
|
| 100 A |
|
MBM100GS12AW |
|
MBB100GS12AW |
|
| 150 A |
|
MBM150GS12AW |
MBM150GS6AW |
|
|
| 200 A |
|
MBM200GS12AW
MBM200JS12AW
MBM200JS12EW |
MBM200GS6W |
|
MBB200GS6AW |
| 300 A |
MBN300GS12AW |
MBM300GS12AW |
MBM300GS6AW |
|
|
| 400 A |
MBN400GS12AW
MBN400GS12BW |
|
MBM400GS6AW
MBM400JS6AW |
|
|
| 600 A |
MBN600GS12AW |
|
MBM600GS6AW |
|
|
| 1200 A |
MBN1200GR12AW |
|
|
|
|
| "Higt Power type" |
| Ic |
Vce |
| одинарный |
chopper |
| 3,300 B |
2,500 B |
2,000 B |
1,700 B |
3,300 B |
| 400 A |
MBN400C33A |
|
MBN400C20 |
|
|
| 600 A |
MBN600C33A |
|
MBN600C20 |
|
|
| 800 A |
|
|
|
|
MBL800D33B |
| 1200 A |
MBN1200D33A |
MBN1200D25B |
|
|
|
| 1800 A |
|
|
|
MBN1800D17C* |
|
*) В стадии разработки. Для более полной информации связываться с представительством.
Без существенного ухудшения теплового сопротивления, IGBT-модули IV поколения уменьшают потери мощности в статическом режиме и режиме переключения, обеспечивая уровень потерь мощности, получаемый при использовании технологии затвора с изолирующими канавками.
В результате, температура частей модулей IV поколения меньше, чем тех же самых частей IGBT-модулей, выполненных по технологии затвора с изолирующими канавками, что является следствием более низкого значения полного теплового сопротивления.
Это также увеличивает время эксплуатации модулей IV поколения. Кроме того, это поколение модулей даёт возможность увеличивать уровень коммутируемой мощности (1700 В и 1200 A), что является идеальным решением для мощных инверторов.
Итак, технология затвора с изолирующими канавками обладает неоспоримыми преимуществами, обеспечивая более низкое значение напряжения насыщения, что особенно важно для низковольтных IGBT-модулей.
Представительство фирмы «Hitachi» в Москве
Тел. (095) 784-4020
Поставки продукции фирмы «Hitachi»,
в том числе и образцов,
производит фирма «Макро Тим» (Москва)
Тел. (095) 306 0026, 306-4721, 306-4789
Факс (095) 306-0283
E-mail: sales@sei-macro.msk.ru
|