| |
М. Горлов, А. Строгонов
Геронтология кремниевых интегральных схем. Часть 1
Введение
Физики уже давно стали применять некоторые медицинские термины для объяснения наблюдаемых явлений в твёрдых телах и изделиях на их основе. Приведём несколько примеров из опубликованных работ [1,2]: “залечивание” пор, пустот в твёрдых телах; эффект памяти в структурах Si – Al2O3 – Al; “имунность” плёнок SiO2 по отношению к воздействию горячих носителей; “аккомодация” кристаллических решёток и тому подобное. На наш взгляд, из медицинской терминологии можно заимствовать ещё и термин “геронтология”, применив его к изучению старения и долголетия изделий электронной техники (ИЭТ) и, в частности, интегральных схем (ИС).
Для нормальной работы в отечественной практике установлено, что интенсивность отказов l для ИС высокой надёжности характеризуется величиной от 10-6 до 10-9 1/ч. и сверхвысокой надёжности — от 10-9 1/ч. и ниже [2]. Учитывая постоянное значение l для этого периода работы изделия, величина средней наработки на отказ T теоретически определяется как T = 1/l. Тогда получим теоретическое среднее время наработки для ИС от 1 млн.ч. до 1 млрд.ч. для схем высокой надёжности и более 1 млрд.ч. — для схем сверхвысокой надёжности, то есть от 114 до 114155 лет и более. В настоящее время в отечественных технических условиях на ИС установлены наибольшие показатели долговечности (наработки) в течение 200 тыс.ч. и гамма-процентного ресурса сохраняемости — 25 лет, что сегодня практически полностью удовлетворяет все виды радиоэлектронной аппаратуры, в которых используются ИС. Но могут ли ИС практически сохранять свою работоспособность в течение 30, 50, 100 и более лет? И если не могут, то изменения каких составляющих конструкций ИС будут при этом преобладать? Какими испытаниями можно подтвердить такую долговечность? Ведь далеко не одно и то же, испытывать миллион ИС в течение одного часа или одно изделие миллион часов, хотя в обоих случаях наработка составит 1 млн. приборо-часов.
Сейчас на эти вопросы найти объективный ответ по имеющейся статистике или расчётными способами практически невозможно, хотя всевозможных моделей прогнозирования длительности работоспособности ИС имеется множество, как и множество работ, посвящённых надёжности ИС через изучение физики отказов, моделирование причин отказов, моделирование и экспериментальное определение надёжности отдельных элементов ИС и в целом схемы. В частности, имеется множество моделей отдельных видов отказов ИС: из-за образования микродефектов в кремнии, из-за электромиграционных отказов металлизации, из-за электрического старения плёнок двуокиси кремния и т.п. Все эти физико-математические модели основаны на изменении физико-химических свойств материалов, происходящих со временем при воздействии внешних факторов, и влиянии этих изменений на работоспособность ИС.
Указанные работы объясняют в той или иной мере причины старения отдельных элементов ИС, но не дают ответ о долговечности ИС. Поэтому геронтология ИС должна изучать старение схем, связанное с самопроизвольным изменением основных их параметров в нерабочем состоянии, то есть при хранении (эффект “чистого старения”) и с быстрым или относительно медленным изменением электрических параметров ИС за счёт влияния электрических нагрузок и дестабилизирующих факторов внешних воздействий. На основе изучения явлений старения необходимо найти зависимости для расчёта реального долголетия ИС, определяемого конструкцией и технологией изготовления. Задача эта непростая, так как ИС представляют собой сложную физическую систему, создаваемую в процессе длительного технологического цикла с использованием различных физико-химических процессов, целью которых является модифицирование свойств полупроводника и формирование топологической структуры, обеспечивающих необходимый комплекс электрических параметров ИС.
Почему мы считаем необходимым изучать геронтологию ИС? На ИС построены все радиоэлектронные системы длительной работы оборонного и космического характера. В настоящее время длительность работы этих систем в активном или дежурном режимах рассчитывается на срок в 10-20 лет. Но дороговизна этих систем требует иногда научного обоснования для продления срока службы. Научной основой для этого и будет геронтология ИС.
Из всего многообразия конструктивно-технологического исполнения ИС в данной работе будут рассматриваться только кремниевые интегральные схемы в корпусном исполнении.
Прогнозирование долговечности ИС по ускоренным испытаниям
Как было сказано выше, в отечественной практике установлено, что интенсивность отказов l для ИС высокой надёжности характеризуется величиной от 10-6 до 10-9 1/ч. и сверхвысокой надёжности — от 10-9 1/ч. и ниже. В зарубежной практике установлены величины от 100 до 1 ФИТ (за единицу интенсивности отказов ФИТ принимается 1 отказ / 109 приборо-часов, то есть 1 отказ на 109 ИС в час) [3]. Требования, предъявляемые по интенсивности отказов ИС для 2001, года составляют 0,1 ФИТ [4]. Для оценок с достоверностью 60% потребуется около 109 приборо-часов без единого отказа. На рис. 1 приведены интенсивности отказов программируемых пользователем вентильных матриц (ППВМ), выполненных по технологии статических оперативных запоминающих устройств (СОЗУ) компании Xilinx — мирового лидера в производстве перепрограммируемых логических схем. Интенсивности отказов получены по результатам ускоренных испытаний (статическая и динамическая электро-термотренировки при температуре 125°С) свыше 20000 приборов в течение двух лет, при этом общая наработка на отказ составила 36 млн. приборо-часов [5].
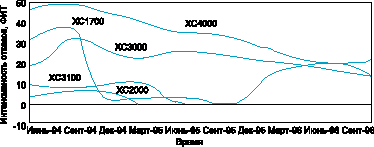
Рис. 1. Интенсивность отказов ППВМ компании XILINX семейства ХС2000, ХС3000, ХС4000
Требования, предъявляемые к отечественным ИС по интенсивности отказов также достаточно жёсткие. Так, в ТУ на ИС серий 106, 134 введена величина гарантийной наработки — 150 тыс.ч., а в облегченном режиме — не менее 200 тыс.ч. ИС серий 582 и 1804 имеют гарантийную наработку 50 тыс.ч. и характеризуются величиной интенсивности отказов порядка 10-7 ё 10-8 1/ч. Надёжность ИС серии 106, 134 по данным изготовителей РЭА оценивалась в 1980 году величиной интенсивности отказов менее 1·109 1/ч., то есть схемы по отечественной классификации обладали сверхвысокой надёжностью.

Рис. 2. Типовая зависимость интенсивности отказов ИС от времени
Зависимость интенсивности отказов от времени работы ИС имеет вид кривой (называемой иногда “ванной”, рис. 2), которая характеризуется тремя периодами: периодом приработки (называемого иногда периодом “детских” или ранних отказов), в котором интенсивность отказов вначале велика, а затем быстро падает; периодом нормальной работы, то есть основной, в котором значение интенсивности отказов постоянно, и периодом старения (износа), в котором интенсивность отказов начинает вначале медленно, а затем более быстрее возрастать. Однако, данная стадия у ИС только предполагается [3].
Испытаниями у изготовителей или потребителей, то есть изготовителей РЭА, подтвердить наличие третьего участка кривой интенсивности отказов, то есть периода старения ИС, довольно трудно, либо не представляется возможным вообще. Так, в литературе встречаются лишь единичные сведения о наработках ИС свыше 10 лет и более, чаще приводятся данные по результатам ускоренных испытаний, достоверность которых для оценки долговечности ИС в условиях нормальной работы не всегда безупречна.
Получены результаты прямых испытаний на долговечность 50 ИС типа 106 ЛБ1 выпуска января 1980 года в течение 130 тыс.ч. и испытаний на хранение 50 ИС того же типа, изготовленных в первом квартале 1977 года, в течение 15 лет в складских условиях. Отказов за время проведения испытаний не наблюдалось [1].
Для многих серий ИС начало периода старения лежит далеко за окончанием срока службы, то есть физическое старение их ещё не наступает. Например, на рис. 3, на кривой зависимости интенсивности отказов от времени представлены области временного проявления дефектов фотолитографии (ФЛ), электрохимического разрушения металлизации ИС (ЭХР), дефектов типа “не функционируют” (ФК), к которым относятся ИС, годные по статическим параметрам, но являющиеся браком по функциональному контролю, и прочие дефекты. К последним относятся: брак по внешнему виду кристалла, дефекты приварки внутренних соединений, трещины на кристалле, выколы кремния под контактной площадкой и другие. Эти данные получены на основе анализа ИС серии 134 (логические биполярные с оксидной изоляцией “карманов”), отказавших в РЭА, выпуска 1984-1992 гг. Видно, что влияние дефектов типа ФЛ, ФК и прочих на надёжность ИС можно рассматривать как “близкое”, а влияние отказов типа ЭХР можно представить как “дальнодействующее”, наличие участка старения для ИС серии 134 в течение 100 тыс.ч. не наблюдается [1].
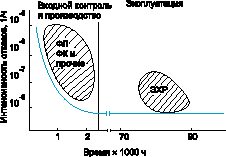
Рис. 3. Области временного распределения дефектов ИС серии 134 у изготовителей РЭА
Cтрогих математических уравнений, определяющих долговечность, не существует, но практически считается, что долговечность ИС обратно пропорциональна прикладываемому напряжению Vg(T) (g(T) — фактор ускорения напряжением при температурной нагрузке T, который для ИС изменяется в пределах от 1 до 4,5), плотности тока ja(T) (a(T) — фактор ускорения плотностью тока при Т изменяется в диапазоне от 1 до 4) и обратному значению абсолютной температуры, то есть среднее время наработки до отказа: tFµV-g(T), j-a(T), const·exp(Ea/kt), где Ea — энергия активации; k — константа Больцмана; T — абсолютная температура перехода. За базовую модель принимается уравнение Аррениуса. Это уравнение приближённо описывает многие деградационные процессы и отказы ИС, в том числе, ионный дрейф, диффузию примесей, образование интерметаллических соединений, ползучесть, кристаллографические микроперестроения конструкционных материалов. Уравнение Аррениуса в равной степени хорошо описывает появления отказов ИС при воздействии повышенной температуры как в период приработки, так и в период старения [1,2].
Прогнозирование долговечности ИС по результатам ускоренных испытаний осуществляется в следующем порядке. Исходя из полученных значений экспериментально найденной энергии активации, рассчитывают коэффициент ускорения и эквивалентный эксплуатационный срок службы ИС по формуле:

где tu — длительность испытаний, Ky — коэффициент ускорения. Надёжностные характеристики при этом (интенсивность отказов, функция и плотность распределения отказов от времени) определяют с помощью наиболее распространённых строго вероятностных распределений: логарифмическое нормальное и Вейбулловское. Функция логарифмического нормального распределения успешно применяется для описания статистики отказов ИС в течение длительного промежутка времени. Практика эксплуатации и опыт ускоренных испытаний показали, что распределение долговечности от температуры описывается лог-нормальным распределением с возрастающей функцией интенсивности отказов. Лог-нормальное распределение также хорошо описывает отказы, когда нагрузкой выступают повышенные влажность и напряжённость электрического поля в оксиде. Распределение Вейбулла наиболее часто используется при прогнозировании долговечно-сти ИС и элементов её конструкции и хорошо описывает времязависимый пробой диэлектрика. Лог-нормальное и Вейбулловское распределения одинаково хорошо описывают отказы ИС вследствие электромиграции [6,7].
Наиболее распространёнными испытаниями ИС на долговечность являются испытания при повышенных температурах. Из них чаще встречаются два варианта [1]:
- при предельных электрических нагрузках и предельной температуре (125–150°C), при допущении корреляции с результатами эксплуатации при температуре 55°C, при времени испытаний в целом не более 1000 ч;
- при температурах, физически допустимых конструкцией ИС (200–300°C), продолжительностью 48–100 ч. и более, исходя из допущения, что при этих нагрузках действуют те же самые механизмы отказов, что и при нормальных условиях эксплуатации.
При высоких температурах (200–300°С), близких к пороговым, можно наблюдать механизмы отказов, относительно редко проявляющиеся при умеренных температурах. Ускоренные испытания КМОП ИС по первому варианту (ускорение отказов с повышением температуры оценивалось по уровню, при котором достигается 10% отказов) дали следующие результаты. Для температуры 125°С средний срок службы ИС определяется 800 ч., для 60°С он равен 60 годам, а для температуры 40°С — 755 лет [2].
В качестве меры, показывающей, как сокращается долговечность за счёт развития дефектов при повышении температуры от T1 к T2, служит коэффициент ускорения Ky. В случае, если действуют m механизмов отказа, для количественной оценки коэффициента ускорения Ky вводится понятие обобщённого коэффициента ускорения:

где qj — доля вероятности отказа ИС в общем потоке отказов вследствие развития j-го механизма отказа; Kyj — коэффициент ускорения при j-том механизме отказа.
Относительно небольшое изменение энергии активации процесса старения вызывает весьма существенное изменение коэффициента ускорения. На рис. 4 показан коэффициент ускорения отказов в зависимости от изменения величины температуры при изменении энергии активации в диапазоне 0,3–1,3 эВ [2]. Фактор ускорения при температуре 40°С принимается равным единице, то есть Ky40 = 1. Повышение температуры до 100°С при энергии активации 1,3 эВ вызывает увеличение коэффициента ускорения примерно в 5000 раз. На рис. 4 приведены также характеристики закона старения, называемого “правилом 10 градусов”. В соответствии с ним принимают, что скорость старения увеличивается вдвое при увеличении температуры на 10°С. Этому закону нарастания скорости старения соответствует энергия активации в пределах 0,7 ё 0,8 эВ.
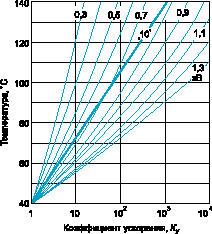
Рис. 4. Зависимость коэффициента усрорения Ку от температуры
Опыт ускоренных испытаний ИС на долговечность показывает, что интенсивность отказов имеет бимодальный характер (рис. 5) [2]. Первый пик в нижней левой части рис. 5 характеризует отказы аномальных ИС, то есть имеющих скрытые дефекты, а второй — отказы основной части выборки.
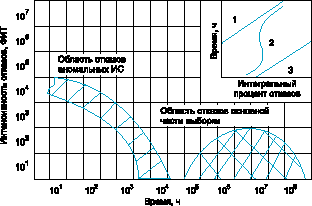
Рис. 5. Типичное распределение интенсивности отказов биполярных ИС, демонстрирующее бимодальный характер отказов, состоящее из двух компонентов лог-нормального распределения: 1 - основное распределение; 2 - объединенное распределение; 3 - аномальное распределение
Трёхмерная картина распределения интенсивности отказов для высокотемпературных испытаний КМОП ИС показана на рис. 6: 1 — распределения для аномальных ИС, 2 — распределения для основной части выборки [1]. Энергия активации для приборов основной части выборки оценивается величиной 1,3 эВ, а для аномальных ИС, как правило, не превышает 0,9 эВ. При +50°С среднее время безотказной работы нормальных ИС составляет 109 ч. (>114000 лет), а для схем с дефектами — 105 ч. (11,4 лет).
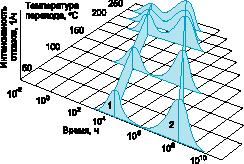
Рис. 6. Интенсивность отказов КМОП ИС при высокотемпературных испытаниях
В случае комбинированных испытаний (одновременное воздействие повышенной температуры и напряжения смещения) интенсивность отказов аномальных ИС зависит только от температуры, в то время как поведение основной части выборки зависит и от температуры, и от приложенного напряжения смещения. В этом случае, для определения tF может быть использована модель Эйринга:

где G, C, D — константы, подлежащие определению; V — напряжение смещения. Модель Эйринга показывает, что при T = const уменьшение V приводит к повышению долговечности. Как видно из рис. 4, время наработки на отказ в условиях, которым отвечает пониженная нагрузка, может в эксплутационных режимах работы в несколько раз превышать установленный срок службы для ИС.
Полученные математические модели отказов элементов конструкции ИС по результатам ускоренных испытаний позволяют создать библиотеку моделей деградации для реализации возможности моделирования процесса старения элементов конструкции ИС на этапе их cхемотехнического проектирования с учётом надёжности, как, например, реализовано в пакете программ BERT [4]. Частично библиотека моделей деградации уже создана для ИС малой и средней степени интеграции (ОСТ 11.073.917-6-80 и ОСТ В11.073.902-78). Однако, эти модели в большинстве случаев не доведены до количественного описания надёжности, хотя их знание способствует повышению надёжности проектируемых ИС, совершенствованию технологического процесса, обоснованному выбору режимов работы ИС.
При использовании результатов ускоренных испытаний ИС на долговечность необходимо принимать во внимание следующее [1,2]:
- отказы, возникающие в условиях повышенной нагрузки, обусловлены механизмами отказов, которые, как правило, не подчиняются зависимости Аррениуса;
- отказы, наблюдаемые при повышенных нагрузках, как правило, связаны с механизмами отказов, не проявляющимися в надлежащим образом спроектированных ИС;
- экстраполяция интенсивностей отказов, определённых в условиях больших нагрузок на область работы в условиях, близких к нормальным, посредством использования моделей Аррениуса, приводит к ложной картине, так как экспериментально получаемая энергия активации значительно выше энергии активации процессов естественного старения примерно на 0,2–0,3 эВ. Это даёт пессимистическую оценку интенсивности отказов, которая, якобы, должна наблюдаться в обычных условиях работы, характеризуемых низким уровнем нагрузки.
Литература
- Горлов М.И., Строгонов А.В. Геронтология интегральных схем: прогнозирование долговечности ИС // Петербургский журнал электроники. — 1996. — № 4. — C. 35–41.
- Горлов М.И., Строгонов А.В. Геронтология интегральных схем: прогнозирование долговечности с использованием ускоренных испытаний // Шумовые и деградационные процессы в полупроводниковых приборах (метрология, диагностика, технология): Материалы докл. науч.-техн. семинара (Москва, 2-5 декабря 1996 г.). — М.: МНТОРЭС им. А.С. Попова, МЭИ. — 1997. — C. 303–311.
- Горлов М.И., Королев С.Ю., Кулаков А.В., Строгонов А.В. Расчёт надёжности интегральных схем по конструктивно-технологическим данным. — Воронеж: Издательство Воронежского университета. — 1996. — 80 c.
- Hu C. The BerKeley reliability simulator BERT: an IC reliability simulator, Microelectr. J., 1992, vol.23, №2, pp. 97–102.
- Xilinx. Quality assurance and reliability, 1997, Nov. 21 (Version 2.0), pp.11-1, 11.
- Горлов М.И., Строгонов А.В. Геронтология интегральных схем: долговечность алюминиевой металлизации // Петербургский журнал электроники. — 1997. — № 1. — C. 27–37.
- Горлов М.И., Строгонов А.В. Геронтология интегральных схем: долговечность оксидных плёнок // Петербургский журнал электроники. — 1997. — № 2. — C. 24–36.
Тел.: (0732) 77 3714
E-mail: mart@fil1.vrn.ru
|