| |
Ренди Ричардс, Гектор Де Лос Сантос (Перевод Ю. Потапова)
MEMS-УСТРОЙСТВА ДЛЯ СВЧ ПРИЛОЖЕНИЙ: НОВАЯ ВОЛНА
MEMS-технология (MicroElectroMechanical Systems) в настоящее время является самой передовой и перспективной технологией производства СВЧ-устройств. Современные требования снижения размеров и веса СВЧ-устройств, расширения их динамического диапазона, уменьшения потребляемой мощности и стоимости, наращивания их интеграции и функциональных возможностей при росте рабочих частот подталкивают разработчиков к созданию новых компонентов и поиску их оптимальных архитектур.
Данный обзор состоит из двух частей. В первой части коротко перечислены основные требования к современным СВЧ-устройствам, а также возможности MEMS-технологии, позволяющие реализовать эти требования. Описаны основы технологии производства микроэлектромеханических систем, в частности, наиболее часто используемых компонентов, таких как катушки индуктивности, варакторы, резонаторы и линии передачи, а также базовые принципы их автоматизированного проектирования.
Во второй части, которая выйдет несколько позднее, будут представлены революционные возможности MEMS-технологии в области новых архитектур и системной интеграции. Например, будет показано, каких результатов можно добиться посредством замены классической реализации входного тракта приемника на систему, использующую СВЧ MEMS-устройства.
Перспективы MEMS-технологии для СВЧ-приложений
Постоянно возрастающие требования к гибкости и сложности, лёгкости и экономичности современных систем связи стимулируют поиск технологий, позволяющих снизить производственные затраты, размеры, вес, потребление и, главное, значительно улучшить технические характеристики СВЧ-компонентов. Все эти качества крайне необходимы для широкого спектра СВЧ-приложений, например, в мобильных телефонах, устройствах беспроводного доступа к сети Internet, для электронной торговли, в системах передачи данных на базе стандарта Bluetooth и устройствах позиционирования на местности, системах GPS. Пока можно с уверенностью сказать, что только технология MEMS может удовлетворить все перечисленные требования:
обеспечить более широкие диапазоны рабочих частот;
почти полный отказ от внешних дискретных компонентов, благодаря чему снижаются омические потери в проводниках;
высокую технологичность производства за счёт использования планарного процесса, а также его совместимости с существующими технологическими процессами изготовления цифровых и СВЧ монолитных интегральных схем (MMIC).
Со временем СВЧ MEMS-технология позволит получить встраиваемые в кристалл коммутаторы сигналов с нулевым потреблением в состоянии покоя, мощностью переключения на уровне единиц нДж и напряжением срабатывания менее 5 В; высокодобротные прецизионные катушки индуктивности, конденсаторы и варакторы; высокостабильные генераторы; высококачественные фильтры, работающие в частотном диапазоне от десятков МГц до единиц ГГц. Наличие такого арсенала СВЧ-устройств обеспечит разработчиков компонентами, которые они так долго ожидали для реализации новых и простых, но в тоже время чрезвычайно функциональных реконфигурируемых систем.
Основные технологии изготовления MEMS-устройств
Под технологиями изготовления MEMS-устройств подразумеваются традиционные технологические циклы изготовления интегральных схем, адаптированные для создания трёхмерных механических структур, а именно: объёмная микрообработка, поверхностная микрообработка и так называемая технология LIGA.
Объемная микрообработка (Bulk Micromachining)
При такой обработке объёмная структура получается внутри подложки благодаря её анизотропным свойствам, то есть различной скорости травления кристалла, в зависимости от направления кристаллографических осей. Иначе, объёмная структура может быть получена методом наращивания, когда несколько подложек сплавляются и образуют вертикальные связи на атомарном уровне (рис. 1).
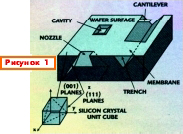
Структура, полученная с помощью объёмной микромеханической обработки
Поверхностная микрообработка (Surface Micromachining)
При поверхностной микромеханической обработке трёхмерная структура образуется последовательным наложением основных тонких плёнок и удалением вспомогательных слоёв согласно требуемой топологии. Преимуществом данной технологии является возможность многократного удаления (растворения) вспомогательных слоев без повреждения взаимосвязей базовых слоёв (рис. 2).
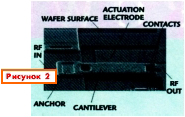
Структура, полученная с помощью поверхностной микромеханической обработки
Технология LIGA
Название технологии LIGA происходит от немецкой аббревиатуры RoentgenLIthography-Galvanik-Abformung, что означает комбинацию рентгеновской литографии, гальванотехники и прессовки (формовки). Здесь толстый фоторезистивный слой подвергается воздействию рентгеновских лучей (засветке) с последующим гальваническим осаждением высоко профильных трёхмерных структур. На рис. 3 изображён 6-дБ ответвитель мощности на копланарных линиях, изготовленный с использованием технологии LIGA.
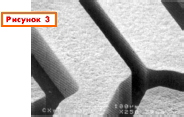
6-дБ копланарный делитель мощности, выполненный по технологии LIGA
MEMS-компоненты: катушки, варакторы, коммутаторы, резонаторы
Суть MEMS-технологии заключается в удалении отдельных областей подложки таким образом, чтобы оставшиеся её части оказались приподнятыми над основной поверхностью, или наоборот в том, чтобы нарастить заданную высокопрофильную структуру над ней. Благодаря этому, появляется возможность преодолеть технологические ограничения на номиналы компонентов. Ниже рассмотрены реализации катушек индуктивности, варакторов, коммутаторов и резонаторов с помощью MEMS-технологии.
Высокодобротные катушки индуктивности
Объёмная микрообработка применяется здесь для того, чтобы значительно снизить проявления паразитных эффектов, присущих традиционным планарным катушкам индуктивности, выполненным на диэлектрических подложках, что приводит к снижению добротности Q и частоты собственного резонанса, и приблизить их к значениям, реализуемым только для внешних навесных элементов. На рис. 4 показан пример катушки индуктивности, выполненной по технологии объёмной микрообработки, у которой из-под спирали удалён диэлектрик. Добротность на частоте собственного резонанса Qs таких катушек лежит в пределах от 6 до 28 на частотах от 6 до 18 ГГц при значении индуктивности порядка 1 нГн. Аналогичным образом с помощью технологии поверхностной микрообработки реализуются катушки индуктивности в виде витков соленоида, возвышающихся над подложкой. На рис. 5 показана фотография такой катушки с индуктивностью 2,3 нГн и добротностью 25,1 на частоте 8,4 ГГц. На рис. 6 показаны характеристики получаемых в настоящее время устройств.
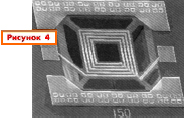 Спиральная катушка, выполненная по MEMS-технологии 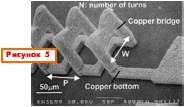 Катушка в виде соленоида, выполненная по MEMS-технологии 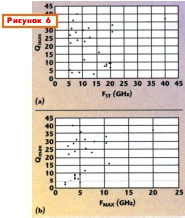 Типовые значения максимальной добротности MEMS-катушек индуктивности, в зависимости от частоты собственного резонанса Fsr (а) и максимальной рабочей частоты Fmax (б)
MEMS-варакторы
Конденсаторы с изменяемой ёмкостью традиционно были трудно реализуемы в монолитных интегральных схемах по целому ряду причин, главным образом из-за несовместимости процессов, направленных на получение параметров, близких к оптимальным. MEMS-варакторы могут быть выполнены двумя различными способами: в виде двух параллельно расположенных пластин (рис. 7) или в виде встречно-штыревой структуры (рис. 8). В случае параллельных пластин верхняя из них представляет собой подвесную пружину, расположенную на некотором расстоянии от нижней. Это расстояние может быть изменено с помощью электростатических сил, вызванных приложенным к пластинам напряжением. В показанном примере номинальная ёмкость пластин составляет 2,05 нФ, добротность на частоте 1 ГГц равна 20, а диапазон перестройки при изменении напряжения от 0 до 4 В составляет 150%, частота собственного резонанса превышает 5 ГГц. В случае встречно-штыревой структуры, показанной на рис. 9, ёмкость конденсатора варьируется посредством изменения степени перекрытия элементов гребенчатых проводников, в зависимости от приложенного к ним напряжения. Такие варакторы имеют, например, ёмкость 5,19 пФ, добротность 34 на частоте 500 МГц и частоту собственного резонанса 5 ГГц. Диапазон перестройки при изменении напряжения от 2 до 14 В составляет около 200%. Точка пересечения третьего порядка (IP3) такого варактора, характеризующая его динамический диапазон или линейность, имеет значение более +50 дБм.
 Рис. 7. MEMS-варактор на основе параллельных пластин 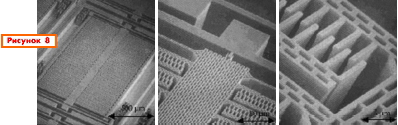 Рис. 8. MEMS-варактор на основе встречно-штыревой структуры 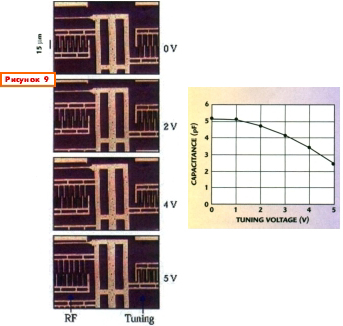 Рис. 9. Изменение степени перекрытия встречных гребенчатых структур, в зависимости от приложенного напряжения. Внизу: зависимость ёмкости такого варактора от приложенного напряжения
MEMS-коммутаторы
MEMS-коммутаторы предлагают разработчикам малые вносимые потери, высокую развязку в разомкнутом состоянии и высокую линейность. Основное внимание разработчиков направлено на получение максимальной скорости переключения и минимального напряжения срабатывания. В настоящее время разработан широкий набор коммутационных устройств, использующих самые разнообразные топологии и механизмы. Здесь используются подвесные консоли, мембраны, сплавы с запоминанием формы, различные схемы "несколько путей/несколько направлений" (рис. 10). Рассмотрим краткое описание наиболее распространённых механизмов:
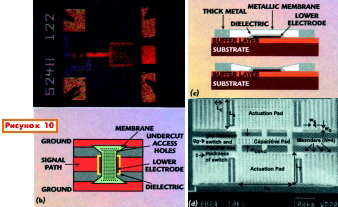 Рис. 10. Различные реализации MEMS-коммутаторов
Электростатический - положительные и/или отрицательные заряды, наводимые приложенным к различным элементам объёмной структуры напряжением, вызывают Кулоновские силы, выполняющие перемещение коммутирующего элемента.
Пьезоэлектрический - приложенное к отдельным элементам объёмной структуры напряжение вызывает изменение их физических размеров, за счёт чего, в свою очередь, происходит коммутация.
Тепловой - протекающий через отдельные элементы объёмной структуры ток вызывает их нагревание, изменяющее физические размеры, за счёт чего происходит коммутация.
Магнитный - коммутация выполняется за счёт магнитных сил, возникающих при протекании тока через определённые элементы объёмной структуры.
Биметаллический (на основе сплавов с памятью формы) - коммутация происходит благодаря свойству некоторых материалов, деформированных при низкой температуре, восстанавливать при нагревании изначальную форму.
Из всего этого разнообразия исполнительных механизмов наиболее часто встречающимся является электростатический. Это обуславливается тем, что для его получения наилучшим образом подходит поверхностная микромеханическая обработка, совместимая с существующими технологиями изготовления монолитных интегральных схем.
Помимо способа приведения в действие, СВЧ MEMS-коммутаторы различаются по типу используемых контактов. Это могут быть ключи с резистивными или контактами металл-металл, а также ключи с емкостными связями, где замыкание цепи происходит через специальное отверстие в тонком изолирующем слое диэлектрика. В то время как резистивные контакты позволяют коммутировать даже цепи постоянного тока, ключи с емкостной связью этого делать не могут. Таким образом, частотные свойства и быстродействие MEMS-переключателей сильно зависят от их типа. В таблице приведены сравнительные характеристики MEMS, MESFET и PIN-диодных коммутаторов.
Микромеханические объемные резонаторы
С помощью микромеханической обработки можно получить микроскопические планарные резонаторы, по характеристикам сходные с макроскопическими волноводными резонаторами. Например, на рис. 11 показан микромеханический объёмный резонатор X-диапазона, который наиболее подходит для интеграции в планарные СВЧ-микросхемы, благодаря совместимости технологий изготовления. Здесь резонатор с размерами 16х32х0,465 мм в ненагруженном состоянии имеет добротность, равную 506. Это всего на 3,8% ниже, чем у классического прямоугольного объёмного резонатора с аналогичными размерами.
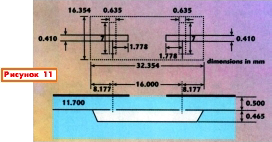 Микромеханический объёмный резонатор X-диапазона
Микромеханические резонаторы
Большие механические резонаторы имеют очень хорошие электрические характеристики, например, их добротность лежит в пределах 10000-25000. Микромеханические резонаторы имеют почти такие же характеристики, но при использовании планарного технологического процесса. Соответственно, имеются два основных подхода к проектированию резонаторов: резонатор вертикального смещения, в котором консольная балка, выполненная в виде трамплина, приводится в вибрацию в ответ на электростатическое возбуждение, и резонатор бокового смещения, в котором движение вызывается посредством возбуждения гребенчатой структуры. Максимальная резонансная частота таких резонаторов, как правило, не превышает 200 МГц. Если необходима работа на значительно больших частотах, например, единицах ГГц, используется толстоплёночная технология FBAR (Film Bulk Acoustic wave Resonator). FBAR-устройство, показанное на рис. 12, состоит из слоя пьезоэлектрического материала (например, нитрида алюминия), расположенного между верхним и нижним электродами. Добротность такого резонатора составляет около 1000, а резонансная частота может лежать в пределах от 1,5 до 7,5 ГГц.
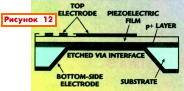 Пьезоэлектрический резонатор, выполненный по технологии FBAR
Микромеханические линии передачи
Большинство физических эффектов, свойственных линиям передачи и вызывающих ухудшение их характеристик, таких как явление частотной дисперсии и, в некоторой степени, вносимые потери, определяются свойствами подложки или среды, осуществляющей перенос энергии. На рис. 13 показаны четыре типа линий передачи, успешно реализованных с помощью MEMS-технологии. В их число входят: микрополосковая линия, размещённая на диэлектрической мембране; копланарная экранированная линия передачи; копланарный волновод с травлением по верхнему слою; микромеханический волновод. В первом варианте микрополосковая линия располагается на тонкой диэлектрической мембране, выполненной из материала с относительной диэлектрической проницаемостью, близкой к единице. Создание пустоты под топологией линии производится травлением обратной стороны подложки. Главным недостатком таких линий передач является отсутствие должной заземляющей поверхности. Копланарная микроэкранированная линия преодолевает этот недостаток посредством включения в топологию верхнего слоя специальных заземлённых проводников, в совокупности образующих структуру "земля-линия-земля". Копланарный волновод с травлением верхнего слоя позволяет избежать потенциальных проблем травления обратной стороны подложки и изготовления экранирующих линий, возникающих в первых двух случаях. Здесь пассивация подложки производится сверху в пределах уже существующего выреза в слое металлизации, в результате чего под ним образуется заполненное воздухом углубление. Наконец, в микромеханических волноводах используется комбинация микромеханической обработки и технологии спекания многослойных подложек, благодаря чему удаётся избежать большинства проблем, присущих традиционным методам механической обработки.
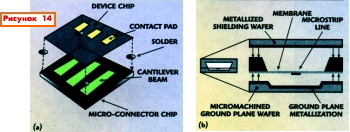 Различные типы MEMS-линий передачи: микрополосковая линия на мембране (a), копланарный волновод с травлением по верхнему слою (б) и микромеханический волновод (в)
Упаковка MEMS-устройств
Не секрет, что залогом высоких электрических характеристик обычных ВЧ- и СВЧ-компонентов является выбор соответствующего конструктивного исполнения или качественная упаковка. MEMS СВЧ-устройства не являются исключением. Действительно, в дополнение к требованиям отсутствия нежелательных резонансов, электромагнитных помех и паразитных связей, методы упаковки MEMS СВЧ-устройств нацелены на защиту от проникновения в механизм влаги и мелких пылевых частиц, способных нарушить его нормальное функционирование, а также на предотвращение потерь энергии различных типов (например, акустической и тепловой). На рис. 14 показаны два примера упаковки MEMS-устройств в корпус. Первый основан на технологии монтажа перевёрнутых кристаллов, в то время как второй использует технику самоупаковки, при которой микромеханические устройства располагаются в пустотах, образованных послойным соединением нескольких подложек.
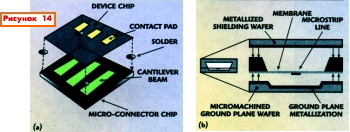 Различные способы упаковки MEMS-устройств: технология монтажа перевернутых кристаллов (a) и технология самоупаковки (б)
Инструментарий для разработки MEMS-устройств
В недалёком прошлом разработка MEMS СВЧ-устройств предполагала длительные и дорогие циклы макетирования. Сегодня вместо них предлагается широкий набор точных, удобных в работе, коммерчески доступных инструментов проектирования MEMS-устройств, позволяющий значительно сократить путь изделия на рынок и снизить материальные затраты. Необходимость этих инструментов происходит из природы MEMS-устройств, а значит они должны позволять производить истинно интегрированный анализ самых различных физических процессов, например, электростатических, механических и тепловых. Качественные проекты MEMS СВЧ-устройств должны учитывать топологию устройства, его конструкцию (включая упаковку), механическое и электрическое моделирование, а также поведенческое моделирование, если предполагается объединение нескольких MEMS-устройств. Методология сквозного проектирования MEMS-устройств показана на рис. 15.
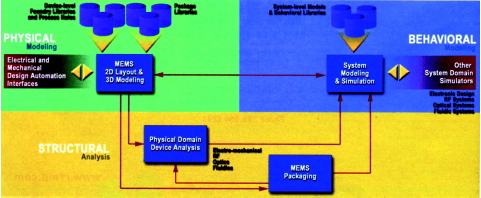 Методология проектирования MEMS-устройств
Литература:
1. De Los Santos H.J. Introduction to Microelectromechanical (MEM) Microwave Systems. Artech House. 1999. P. 4-9.
2. Holmes A.S. and Saidam S.M. Sacrificial Layer Process with Laser-driven Release for Batch Assembly Operations. Journal of Microelectromechanical Systems. Vol. 7. No. 4. December 1998.
3. Willke T.L., Onggosanusi E. and Gearhart S.S. Micromachined Thick-metal Coplanar Coupled-line Filters and Couplers. IEEE MTT-S International Microwave Symposium Digest. Vol. 1. 1998. P. 115-118.
4. Sun Y., H. van Zeijl, Tauritz J.L. and Baets R.G.F. Suspended Membrane Inductors and Capacitors for Application in Silicon MMIC's. Microwave and Millimeter-wave Monolithic Circuits Symposium Digest of Papers. IEEE. 1996. P. 99-102.
5. Yoon J.B., Kim B.K., Han C.H., Yoon E. and Kim C.K. Surface Micromachined Solenoid On-Si and On-glass Inductors for RF Applications. IEEE Electron Device Letters. Vol. 20. No. 9. September 1999. p. 487.
6. Dec A. and Suyama K. Micromachined Electro-mechanically Tunable Capacitors and Their Applications to RF IC's. IEEE Transactions on Microwave Theory and Techniques. Vol. 46. No. 12. December 1998. p. 2587.
7. Yao J.J. Topical Review: RF MEMS from a Device Perspective. J. Micromech. Microeng. 10 (2000) R9-R38.
8. Pacheco S.P., Katehi L.P.B. and Nguyen C.T.C. Design of Low Actuation Voltage RF MEMS Switch. IEEE MTT-S International Microwave Symposium Digest. Vol. 1. 2000, P. 165-168.
9. Papapolymerou J., Cheng J.C., East J. and Katehi L.P.B. A Micromachined High X-band Resonator. IEEE Microwave and Guided Wave Letters. Vol. 7. No. 6. June 1997.
10. Krishnaswamy S.V. et al. Compact FBAR Filters Offer Low Loss Performance. Microwaves & RF. September 1991. P. 127-136.
11. Weller T.M., Katehi L.P.B., Herman M.L., Wamhof P.D., Lee K., Kolawa E.A. and Tai B.H. New Results Using Membrane-supported Circuits: A Ka-band Power Amplifier and Survivability Testing. IEEE Transactions on Microwawe Theory and Techniques. Vol. 44. No. 9. September 1996. p. 1603.
12. Ozgur M., Milanovic V., Zincke C., Gaitan M. and Zaghloul M.E. Quasi-TEM Characteristic Impedance of Micromachined CMOS Coplanar Waveguides. IEEE Transactions on Microwave Theory and Techniques. Vol. 48. No. 5. May 2000.
13. McGrath W.R., Walker C., Yap M. and Tai Y.C. Silicon Micromachined Waveguides for Millimeter-wave and Submillimeter-wave Frequencies. IEEE Microwave and Guided Wave Letters. Vol. 3. No. 3. March 1993. p. 61.
14. Miller D.C., Zhang W. and Bright V.M. Microrelay Packaging Technology Using Flip-chip Assembly. The Thirteenth Annual International Conference on Micro Electro Mechanical Systems. 2000. P. 265-270.
15. Robertson S.V., Katehi L.P.B. and Rebeiz G.M. Micromachined Self-packaged W-band Bandpass Filters. IEEE MTT-S International Microwave Symposium Digest. Vol. 3. 1995. P. 1543-1546.
Microwave Journal, март 2001 г.
|