| |
Рон Нил
Будущее за полевыми программируемыми устройствами
Oснова полевых программируемых устройств будущего — базовые программируемые элементы уже появились на горизонте. Такие устройства, как одноэлектронные модули памяти (SEM), новые модули EEPROM и FePROM, свежей струей влились в ряды привычных энергонезависимых программируемых устройств и бросили вызов традиционным технологиям, совершенствование которых связано с уменьшением геометрических размеров ячеек, например, многоуровневых запоминающих устройств.
Для того, чтобы какие-либо новые структуры программируемых устройств получили всеобщее признание, от них требуется значительное улучшение характеристик по сравнению с уже существующими устройствами, например, времени доступа, записи/стирания, долговечности или плотности расположения ячеек. Равным образом, для новых структур будет важна технологическая совместимость с существующими производственными процессами или незначительные изменения в них, а также возможность объединения со встроенной логикой и другими типами памяти, например SRAM, DRAM, FlashPROM.
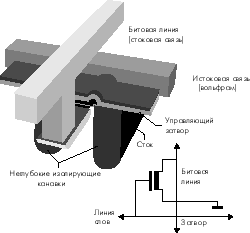
Рис. 1. Структура 0,44 мкм2 NOR ячейки флэш-памяти производства компании TOSHIBA, изготовленной по 0,25-микронной технологии
Примером одной из традиционных технологий, с которой новым устройствам придётся помериться силами, является подход компании Toshiba [1] к реализации встраиваемой ячейки NOR флэш-памяти, изображённой на рис. 1. Однобитовая ячейка занимает площадь 0,44 мкм2 (то есть, нескоммутированная матрица памяти имеет плотность 220 Мбит/см2). Для организации контактов истока, стока и затвора в ячейке используются неглубокие изолирующие канавки. Истоковая связь в устройстве выполнена вольфрамовыми проводниками с низким сопротивлением.
Одноэлектронные запоминающие устройства
Одноэлектронные запоминающие устройства в последнее время развиваются чрезвычайно быстро. Такие устройства, работающие при комнатной температуре, были впервые представлены компанией Hitachi в 1993 году. Первые микросхемы объёмом 64 бит продемонстрированы в 1996, а в 1997 году появился прототип объёмом 128 Мбит [2].

Рис. 2. Динамика развития одноэлектронных запоминающих устройств в сравнении с обычной памятью
На рис. 2 изображён график, иллюстрирующий сравнение динамики развития одноэлектронных запоминающихся устройств (SEM) и традиционных устройств памяти. Емкость, которую можно получить на одном кристалле, использующем одноэлектронную технологию, составляет от 4 до 256 Гбит, что позволит хранить в цифровом виде полноформатный видеофильм всего в одной микросхеме.
Разумеется, разработчикам придётся пройти трудный путь от прототипа объёмом 128 Мбит до серийного производства и решить массу технологических проблем.
Одноэлектронные запоминающие устройства, используемые для реализации 128-Мбит модуля, были получены на основе естественным образом сформированной структуры — термически полученных нанокристаллов. Основной проблемой развития этой технологии является переход от случайным образом полученной структуры к структуре со строго определёнными параметрами, изготовленной по заданному технологическому процессу.
Чтобы яснее понять отличия между структурами, полученными искусственным и естественным путем, а также связанные с этим проблемы, обратимся к рис. 3, где показано семейство одноэлектронных или квантовых устройств, на которых в настоящее время сконцентрированы главные усилия разработчиков.
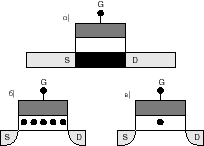
Рис. 3. Три типа квантовых транзисторов
Все три устройства используют так называемые квантовые точки. На рис. 3а изображено устройство, используемое в качестве базовой ячейки для разработанных компанией Hitachi модулей памяти объёмом 128 Мбит. Оно имеет структуру, подобную обычному МОП-транзистору, с той разницей, что область между истоком и затвором представляет собой очень тонкую нанокристаллическую кремниевую плёнку. Вещество плёнки первоначально осаждается в аморфном состоянии, а затем кристаллизуется под воздействием высокой температуры.
Естественным или искусственным образом сформированные нанокристаллы могут работать как сверхмалые области проводимости, где электроны могут накапливаться и образовывать вокруг этой области кулоновский барьер или блокаду, которая может управлять амплитудой тока, протекающего между истоком и стоком устройства, в зависимости от параметров смещения.
Действие устройства и его способность работать как энергонезависимая ячейка памяти зависит от случайного формирования нанокристаллов, локализирующихся на потенциальной поверхности между истоком и стоком настолько близко к каналу протекания тока, что они могут влиять на проводимость этого канала.
В представленном прототипе для подавления некоторых статистических эффектов, связанных со спецификой технологии изготовления, была использована комбинация методов эталонных ячеек и проверки записи.
Из преимуществ устройств на основе нанокристаллов следует отметить высокую скорость записи/считывания, высокую плотность расположения ячеек и совместимость с существующими технологическими процессами. Всего этого достаточно, чтобы преодолеть любые скептические настроения.
Искусственно сформированные квантовые точки
В противоположность выше описанной структуре, изображённое на рис. 3б устройство имеет ряд квантовых точек, расположенных в оксидном слое затвора МОП-структуры, в то время как устройство (рис. 3в) имеет здесь только одну квантовую точку, полученную методом фотолитографии.
Устройство, изображённое на рис. 3б, привлекло внимание представителей корейской компании LG Semicon [3]. Они разработали легко управляемый технологический процесс формирования квантовых точек в структурах устройств EEPROM, хотя здесь также присутствует элемент случайности, относящийся к тому, каким образом и где будет сформирована квантовая точка. Спецификой данного технологического процесса является методика получения кремниевых шариков на поверхности нитрида в обычном LPCVD-реакторе при температуре 620°C, так как предыдущая технология получения квантовых областей в слое оксида кремния SiO2 имела меньшую топологическую воспроизводимость. Результатом обработки нитридного слоя является поверхность из сферических квантовых областей диаметром 4,5 нм с плотностью заполнения 5х1011 точек на квадратный сантиметр.
Характеристики полученного КМОП-устройства показаны на рис. 4. При увеличении напряжения затвора устройство становится управляемым, и имеется очевидное доказательство наличия эффекта квантовых точек, заключающееся в появлении ступенек на зависимости тока стока от напряжения на затворе, соответствующих накоплению различного количества электронов (от 0 до 3). Время хранения информации в таком устройстве для порогового напряжения 2,4 В составляет 104 секунд или 30 лет.
Аналогичное МОП-устройство было разработано в калифорнийском университете в Беркли, но здесь главные усилия были направлены на создание МОП запоминающего устройства, имеющего слой германиевых нанокристаллических квантовых точек диаметром 25 A, точно размещённых в оксидном слое затвора. Используемая технология подразумевает создание трёх затворных слоёв. Из среднего — слоя GeSi02 осаждается германий.
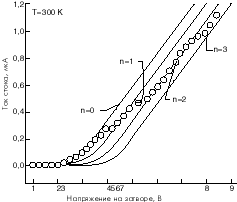
Рис. 4. Зависимость тока стока от напряжения на затворе во время программирования. Непрерывные линии соответствуют Id = f(Vd), когда квантовые области содержат 0, 1, 2 и 3 электрона
Первые полученные устройства показали скорость записи/стирания 100 нс при ±4 В, что соизмеримо с быстродействием динамического ОЗУ (DRAM), а время хранения информации после 109 циклов записи/считывания (с учётом снижения его на 5%) составило 105 секунд или 50 лет.
Зависимость порогового напряжения от времени программирования наблюдалась до состояния насыщения, и это интерпретировалось как подтверждение наличия конечного числа нанокристаллов, принимающих всего один электрон с последующим проявлением эффекта кулоновской блокады, предотвращающим получение второго электрона.
Устройства на диэлектрических подложках
Традиционно считается, что удачная однокристальная специализированная микросхема (ASIC) должна содержать модули электрически стираемого ПЗУ (EEPROM) и флэш-памяти, реализованных на кристалле кремния. А что, если подложка будет изготовлена из диэлектрического материала, например кварца, как это могло быть в случае интеграции в одном устройстве формирователей и логических схем на основе тонкоплёночных транзисторов (TFT), требующих наличия модулей EEPROM?
Над данной проблемой в настоящее время работают специалисты корейских компаний KAIST и Samsung [5], которые уже разработали технологию, позволяющую строить TFT-модули EEPROM на кварцевых подложках.
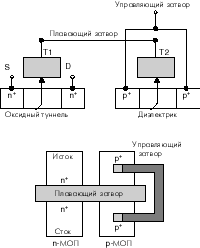
Рис. 4. Структура ячейки EEPROM на тонкопленочных транзисторах (TFT)
Применяемые в таких устройствах структуры состоят из одного МОП-транзистора с n-каналом и одного МОП-транзистора с p-каналом с общим плавающим затвором (рис. 5). Устройства были изготовлены с использованием технологии отжига эксимерным лазером (ELA) или технологии кристаллизации твёрдой фазы совместно с плазменным формированием затвора. Электрические характеристики таких комплементарных МОП-устройств показаны на рис. 6. Модули обеспечивают 105 циклов записи/стирания (запись происходит при напряжении +12 В, а стирание — при -11,5 В. Зависимость пороговых напряжений записи и стирания от числа циклов показывает, что изготовленные по технологии ELA поликремниевые устройства превосходят напылённые поликристаллические (SPC).
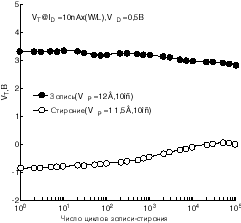
Рис. 6. Зависимость характеристик TFT-модулей EEPROM на кварце от числа циклов записи/стирания
Однокристальные устройства, изготовленные по технологии “кремний на изоляторе” (SOI), обладают преимуществами, связанными с работой на диэлектрической подложке из высококачественного кремния. Технология SOI уже получила признание у разработчиков цифровой логики, SRAM и DRAM, и воспринимается ими как наиболее перспективная технология ближайшего будущего. Если технология SOI будет использоваться для создания однокристальных устройств, то потребуется соответствующее решение задачи построения энергонезависимой памяти на базе этой технологии, что и сделали представители подразделения NVM Technology Centre компании Motorola [6], разработав SOI сдвоенные поликремниевые ячейки памяти EEPROM.

Рис. 7. Структура ячейки флэш-памяти, изготовленной по технологии SOI
В то же время, успешная разработка ячеек EEPROM потребовала создания специальных высоковольтных формирующих устройств.
На рис. 7 схематически показана структура ячейки флэш-памяти EEPROM на базе одного транзистора с самосовмещённым затвором, имеющего туннельный оксидный слой толщиной 95 A. Тело ячейки остается полностью “плавающим”. Ячейка SOI использует туннелирование Фоулера-Нордхейма как для записи, так и для стирания. Во время записи в ячейку низкого логического уровня происходит туннелирование электронов от плавающего затвора к стоку, последний при этом не перекрывается плывущим затвором. Запись завершается туннелированием от канала до плавающего затвора. При этом стоит отметить преимущества, которые обеспечивает использование технологии SOI по сравнению с КМОП-устройствами на монолитных подложках.
Для функционирования монолитных устройств необходима организация структуры из трёх карманов, которая позволяет сохранять низкий уровень на отрицательном p-кармане в процессе программирования. В противоположность этому, плавающее тело SOI-устройства программируется отрицательным напряжением смещения, приложенным к истоку, который после этого переводит плавающее тело в отрицательное состояние. Кроме того, технологический процесс SOI имеет количество этапов на один меньшее, чем КМОП- процесс.
Во всех других отношениях характеристики SOI-устройств соответствуют КМОП-устройствам на монолитных подложках. При записи у SOI несколько меньше напряжение VT при числе циклов записи/стирания 105 по сравнению с КМОП-устройствами. Предположительно, это происходит из-за инжекции большего числа электронов или меньшего числа “дырок” при приложении отрицательного напряжения к телу ячейки во время программирования.
Проблема увеличения напряжения пробоя SOI-устройства при низком напряжении смещения на за-творе с 5 В до более чем 10 В, которая наблюдалась в КМОП-устройствах, была решена созданием структуры, где исток электрически привязан к телу ячейки. В такой структуре используется исток, состоящий из чередующихся дополнительных областей с проводимостью n- и p-типа. Каждое отдельное устройство представляет собой набор параллельных структур исток–сток (рис. 8), где области с проводимостью n- и p-типа связаны единым истоковым выводом.

Рис. 8. Структура с привязанным к телу ячейки истоком позволяет достичь большего напряжения пробоя для SOI-устройств
Области с проводимостью p-типа располагаются под затвором и образуют канал для протекания тока исток–сток. Такая структура обеспечивает требуемое напряжение пробоя большее 10 В и по характеристикам соответствует большинству МОП-устройств с каналом n-типа.
Встраиваемая логика на сегнетоэлектриках
Альтернативный подход к реализации встраиваемых энергонезависимых запоминающих устройств предлагает использование сегнетоэлектрических ячеек памяти. По мнению специалистов компании NEC [7], ключом к успеху этих устройств является разработка технологии изготовления, совместимой с существующим 0,25-мкм КМОП-процессом.
Представители компании также признают, что характеристики сегнетоэлектрических материалов, осаждённых на начальных этапах технологического процесса, деградируют в ходе процесса и особенно это относится к параметрам остаточной поляризации.
Таким образом, любое техническое решение не должно использовать для построения сегнетоэлектрической емкостной структуры ма-ериалы, которые могут повредить транзисторы и стать причиной ухудшения характеристик. Новая сегнетоэлектрическая структура, изображённая на рис. 9, изготовлена по технологии FeRAM, перенесённой на конечные этапы стандартного КМОП- процесса.
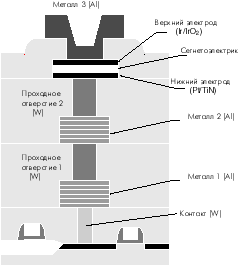
Рис. 9. Сегнетоэлектрическая энергонезависимая ячейка памяти, получаяемая на конечных этапах КМОП-процесса
Это означает, что в процессе имеется только один этап — заключительная пассивация, влияющая на свойства сегнетоэлектрических материалов.
Новое устройство изготовлено с использованием специально разработанной низкотемпературной технологии MO-CVD, с температурой камеры 180°C и подложки 450°C, что несколько лучше по сравнению с технологией PZT, имеющей температуру 600°C и выше.
Полученный сегнетоэлектрик входит в полное насыщение при напряжении 5 В, в то время как поляризация при 2,5 В насыщается не полностью. Величина 2Pr составляет более 10 мкК/см2. Тестирование устройств не показало отсутствие ухудшения параметров при 109 циклов записи/стирания.
Литература
- Novel 0,44mm2 Ti-Salicide STI Cell Technology for High Density NOR Flash memories and High Performance Embedded Application, by H Watanabe et al, Proc IEDM 98, pp. 975–978.
- Electronic Engineering April 1998, “ISSCC ’98 — A memorable year for new memory technology”, pp. 32–34.
- Room Temperature Single Electron Effects in Si Quantum Dot Memory with Oxide-Nitride Tunnelling Dielectrics, Ilgweon Kim et al, Proc IEDM-98, pp. 111–114.
- MOS Memory Using Germanium Nanocrystals Formed by Thermal Oxidation of SiGe, Ya-Chin King et al, Proc IEDM-98, pp. 115–118.
- Highly Reliable Liquid Phase Deposited SiO2 with Nitrous Oxide Plasma Post-treatment for Low Temperature Processed Poly-Si TFTs, C.F. Yeh et al, Proc IEDM-98, pp. 269–272.
- An Advanced Flash Memory Tech-nology on SOI, David Burnett et al, Proc IEDM-98, pp. 983–986.
- Capacitor on Metal Via stacked Plug (CMPV) memory cell for 0.25 mm CMOS embedded FeRAM, Kazushi Amanuma et al, Proc IEDM-98, pp. 363–366.
Electronic Engineering,
февраль 1999 г.
|